- 首页 > 成功案例 > BGA自动植球机返修案例
MTK 联发科凹坑型PoP BGA植球整体解决方案
MTK芯片由于较高的性价比,被广泛应用在众多手机设计中。在生产制造或对其作不良分析时,均需要对其进行返修重焊,但因其芯片设计上采用凹坑内植球焊锡的原因,人工除锡植球难度很大,成功率极低,造成大量产品报废。
下面我们将依据实际案例来介绍一下,通过我司设备整体解决方案来实现对它的返修及焊接。
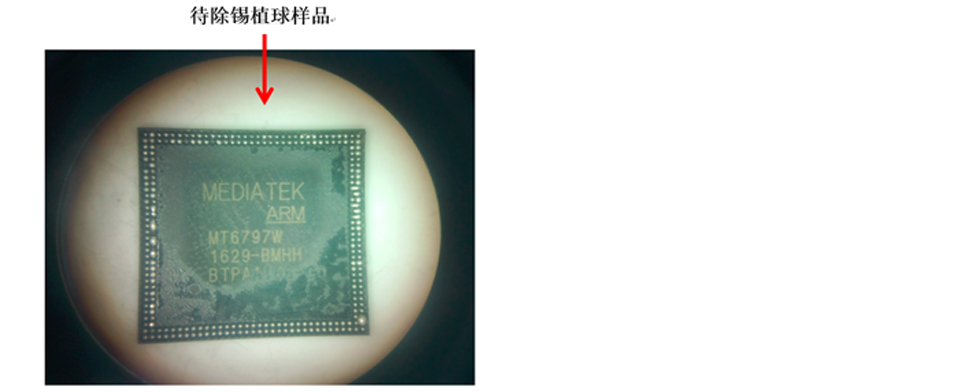
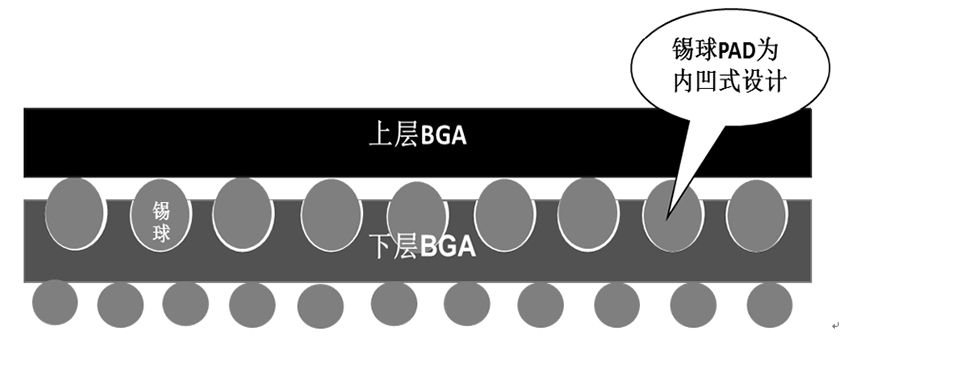
由于采用的是凹坑式植球,所以很难通过手工将残锡清除干净!
一、验证标准与要求:
1、目的/用途:
在电子部件制造过程中发生的需要对BGA类产品进行返修,如:
1.1 手机、平板、电脑PCBA上BGA(POP)的拆$焊;
1.2 单颗BGA芯片的除锡/植球再利用;
1.3 不良BGA的分析,判定原因需要植球再焊接或测试;
2、要求:
2.1 在拆焊BGA时,不能对BGA或PCBA的外观与功能造成损伤。
2.2 在对BGA进行除锡时,需要进行非接触式安全除锡。
2.3 在对BGA进行植球后,BGA的球径$Pitch需要与来料原装一致。
二、验证标准与要求-主要应用流程说明及要求:
三、验证BGA植球返修整体解决方案设备资料
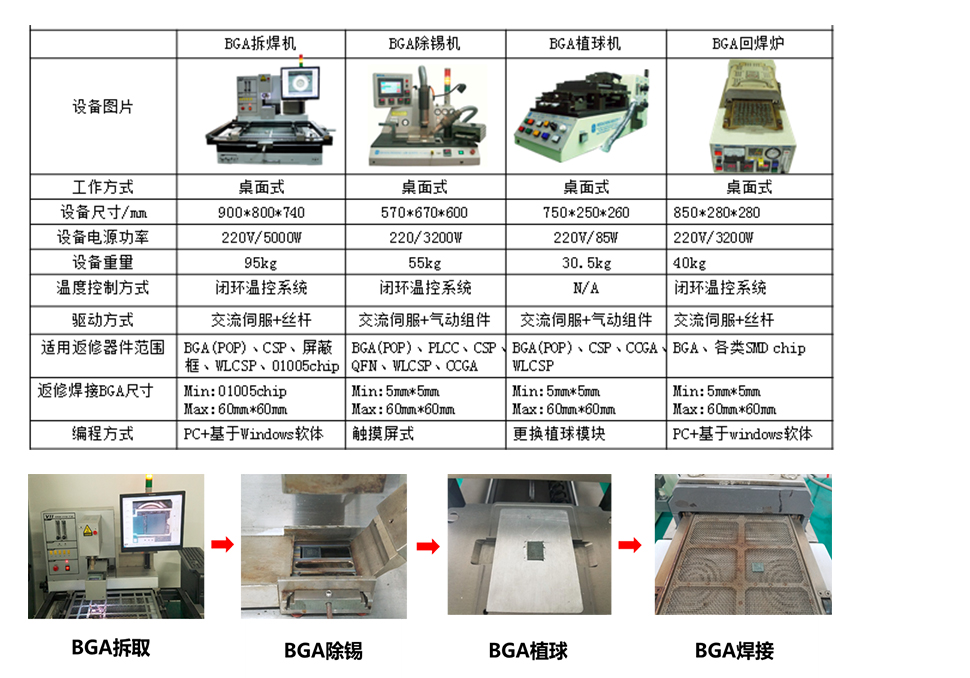
四、验证结果图示
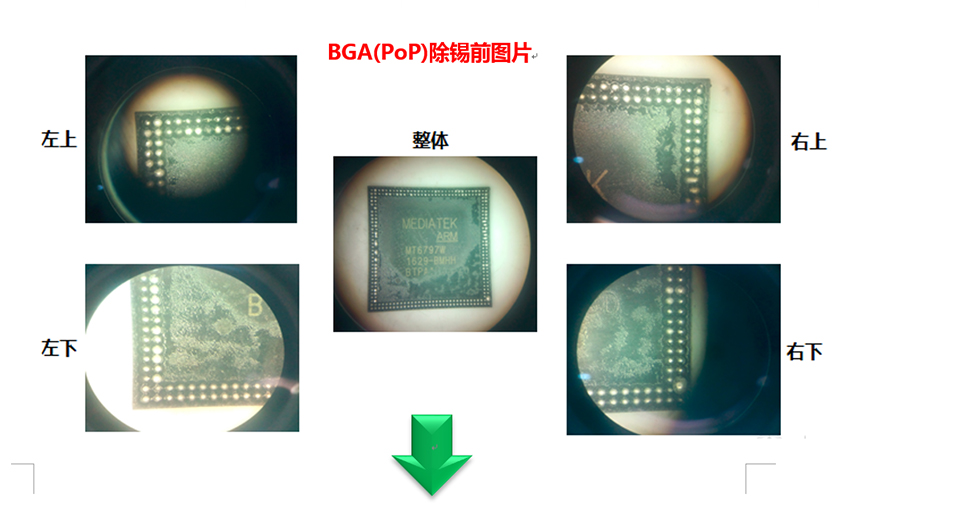
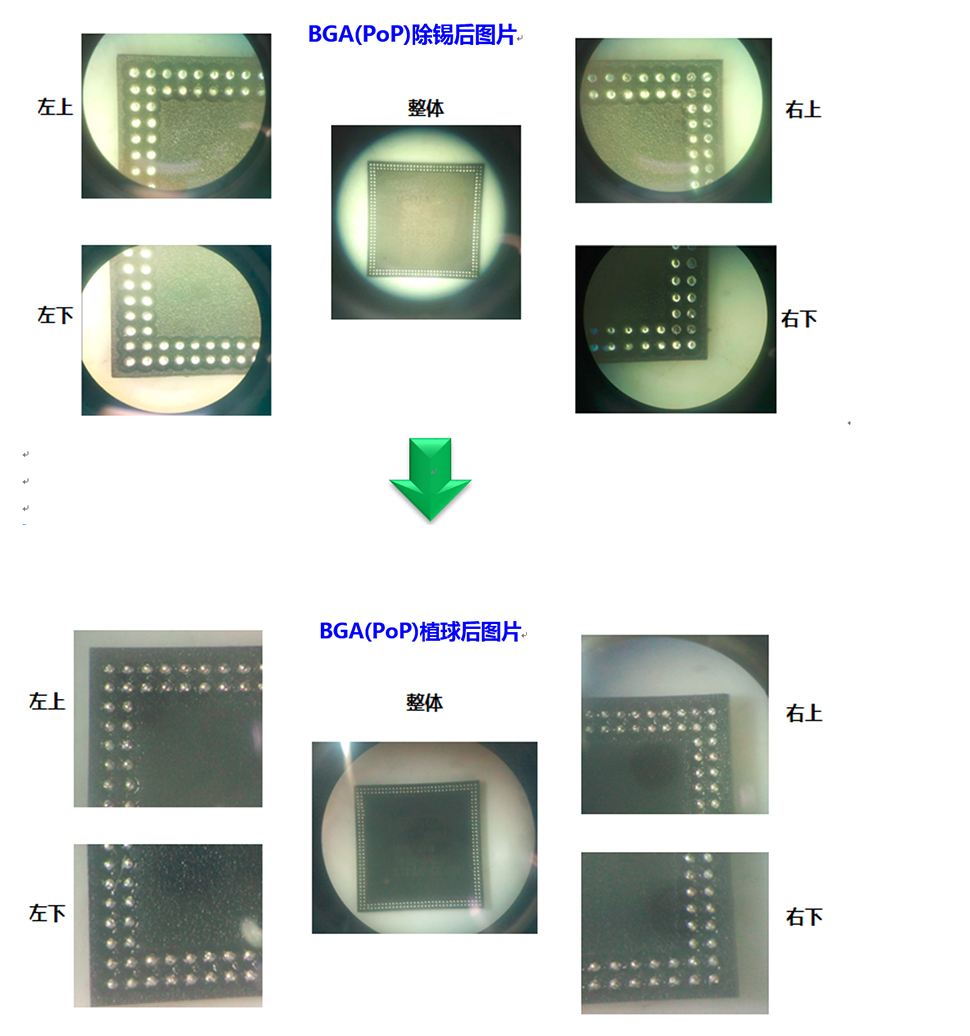
五、品质可靠性检测结果
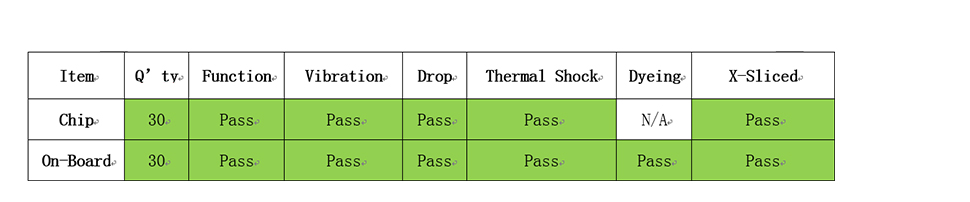 如需了解更多,请登录网址:http//: www.vttech.cn或致电:+86-769-23226000咨询,谢谢!
如需了解更多,请登录网址:http//: www.vttech.cn或致电:+86-769-23226000咨询,谢谢!